
發布時間:2021-12-28作者來源:金航標瀏覽:4613
微系統三維異質異構集成技術是實現未來射頻電子系統更高集成度、更高性能、更高工作頻率等需求的[敏感詞]前景的技術,文中對射頻微系統集成技術在軍民領域的應用需求及前景進行了分析,對其技術內涵及技術體系進行了系統性總結,闡釋了微系統集成技術在滿足系統工程化應用情況下在設計仿真、熱管理、測試、工藝和可靠性等方面所面臨的新挑戰及其解決方案,同時提出了射頻微系統集成技術的進一步發展思路。

摩爾定律已接近物理極限,但未來電子信息系統將持續向更高集成度、更高性能、更高工作頻率等方向發展,傳統的集成封裝技術逐漸難以滿足新型系統集成要求。未來的技術發展趨勢將是延續摩爾定律與超越摩爾定律結合起來,通過三維異構異質集成,實現更高價值的系統———微系統。微系統集成技術通過在微納尺度上采用異構、異質方法集成,是實現更高集成度、更高性能、更高工作頻率需求的主要手段。射頻微系統集成技術作為系統微型化趨勢下的先進集成封裝技術,已經成為引領裝備發展、推動電子技術創新的重大基礎技術,是支撐電子信息裝備在傳感、通信領域能力變革的重要技術平臺,同時也是當前電子信息技術研究的核心技術之一。
本文對射頻微系集成技術在軍民領域的應用需求及前景進行了分析,對其技術內涵進行了系統性總結,梳理出微系統集成技術在設計仿真、工藝集成和測試驗證三個方面的體系框架,對技術面臨的挑戰與發展機遇進行了研判,同時提出了射頻微系統集成技術研究的進一步發展思路。
1 射頻微系統微集成技術概述
1.1 射頻微系統集成技術在軍民市場的應用

在軍用領域,未來[敏感詞]智能化作戰需求將更加依賴于高集成度的電子信息系統,新一代雷達、通信、電子戰等前沿[敏感詞]的研制對射頻微系統集成提出了迫切的需求。射頻微系統集成可以在微納尺度上基于新理念與新工藝實現功能模塊或子系統高度集成化,進而宏觀上實現[敏感詞]體積與功耗大幅降低、性能與可靠性大幅提升、通道成本與全壽命周期成本大幅降低、支持多功能并逐步具備智能化等特征。
在民用領域,5G/6G 通信、物聯網、無人駕駛、太赫茲成像、生物醫療等領域都對射頻微系統集成提出了廣泛的應用需求。穿硅過孔( TSV) 技術、穿玻璃過孔( TGV) 技術、圓片級封裝( WLP) 技術、三維堆疊等三維異質異構集成技術將前端射頻收發器件、數據處理器件、高頻存儲器件、高效電源等進行整合,能夠大幅提升產品的功能,降低器件互聯的延遲與射頻傳輸不匹配性,實現信號的高頻、寬帶、高速傳輸,進而有效降低產品的功耗和體積。圖 2 為愛立信聯合IBM 實現的 5G 射頻微系統,實現了 64 通道的天線陣列高密度一體化集成。圖 3 為新加坡 A-STAR 研究所發布的汽車雷達方面的研究成果,其利用 TSV 技術結合新穎的嵌入式晶圓級封裝技術制作了一款77 GHz 的汽車雷達。
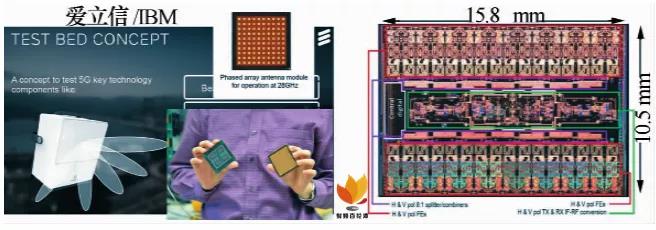

圖3 A-STAR 研究所基于晶圓級射頻微系統封裝的77 GHz 雷達
1.2 射頻微系統集成技術內涵
應用于射頻微系統的三維異質異構集成技術是以微納制造及微連接先進封裝工藝為基礎,融入微電子、微機械、微光學、微能源、微流動等各種先進工藝技術而發展起來的射頻微系統專用制造技術,可實現先進射頻系統架構制造,大幅提升性能,解決集成瓶頸問題。在射頻應用領域,例如探測感知的雷達陣面集成,微加工工藝技術主要解決射頻微系統小型化、多功能集成、高可靠的應用需求。其關鍵技術包含 TSV/TGV封裝基板制造技術、多功能低損耗三維異質集成技術、寬帶大功率三維異構集成技術等 。同時,微加工工藝也應具備工藝過程測試、系統測試及可靠性驗證能力。一方面,及時發現工藝缺陷并優化改進,提高微加工的成品率; 另一方面,對射頻微系統進行性能測試驗證并保證系統可靠性。
1.3 射頻微系統集成技術體系

圖 4 射頻微系統集成技術體系
1) 射頻微系統設計仿真技術
射頻微系統設計仿真包括三維集成架構設計、多物理場聯合仿真兩方面內容。
三維集成架構設計包括電路模塊的分布設計、立體射頻傳輸架構設計和串擾屏蔽設計技術。實現立體集成封裝中有源、無源電路網絡的信號完整性、電源完整性評估,避免電磁干擾。最終可完成射頻微系統中收發通道、電源管理、控制和功分網絡等功能性設計內容。多物理場聯合仿真包括熱 - 機 - 電協同仿真、可靠性評估仿真設計等內容。由于射頻系統微型化后,在三維封裝中電磁、熱、應力等多種物理場相互耦合,已形成混合多物理特性兼容問題,射頻微系統將會遇到散熱、結構可靠性、加電工況可靠性等問題。因此,需要采用多物理場聯合仿真,實現射頻微系統內的熱效應分布以及散熱通道設計,實現射頻微系統系統機、電、熱以及電磁兼容等問題綜合設計 。
2) 三維異質異構集成技術
( 1) 高密度封裝基板構成了射頻微系統集成的基礎框架,在射頻微系統架構中,實現各射頻模塊和射頻子系統之間電學互連、功能集成、結構支撐等功能。需要具備 TSV/TGV 封裝基板工藝能力、片上有源集成工藝能力、片上無源集成工藝能力、片上熱管理基板工藝能力。要滿足射頻微系統復雜電學互聯、低損耗傳輸、高集成等需求,相關微加工工藝能力需要包括硅基/玻璃基高深寬比刻蝕、有源芯片埋置、多層重布線、片上阻容感( RCL) 集成等工藝技術能力 。
( 2) 三維異質集成提供了射頻微系統多功能芯片器件集成的解決方案,通過超高速、高精度低功耗數模混合電路加工以及超高頻、大功率微波毫米波電路加工能力,滿足射頻微系統中多功能射頻和數字處理芯片的微加工需求,包含高速高精度大寬帶數模/模數轉換( DAC/ADC) 異質集成、化合物半導體與硅基單片異質集成等核心技術。
( 3) 三維異構集成工藝具有將射頻微模組、光電傳輸微模組、信號處理微模組等以異構形式結合的天然優勢,滿足多功能射頻微系統集成需求。三維異構集成工藝需要高一致性微凸點工藝、高精度芯片到晶圓高密度微連接工藝、晶圓級三維堆疊工藝幾項能力。為了滿足射頻微系統立體、高精度、小節距微加工需求,需要合金和金屬凸點制備技術、高精度倒裝焊接技術、晶圓鍵合技術等關鍵技術能力。
3) 射頻微系統集成工藝過程測試與驗證技術
射頻微系統需要進行各步驟工藝質量監控、失效分析、電路無損檢測及故障排查診斷,需要具備微加工工藝過程測試與驗證能力,其中可細分為兩塊內容: 微加工集成工藝過程測試驗證和射頻微系統電性能測試驗證。具體根據射頻微系統 TSV/TGV 基板、功能層晶圓等部件的電性能、材料應力測試需求,可進一步細分為 TSV/TGV 封裝基板電性能測試技術、微加工工藝應力與熱失效檢測分析技術等關鍵技術。
2 射頻微系統集成技術
2.1 射頻微系統集成技術優勢為產業發展帶來機遇
射頻微系統技術的優勢概括起來就是“更小、更多、更強、更新”。更小指的是系統集成尺度由粗放的宏觀尺寸向精細的微納尺寸發展,表現為體積、重量、功耗等顯著減小; 更多指的是系統功能由單一功能向多功能發展,功能密度提高 1~2 個數量級; 更強指的是系統性能更強,除了帶寬、速度的顯著提高,更是向可重構、自適應、自主化等智能化水平的發展; 更新指的是采用新的集成手段使新概念、新體系、新模式在微系統中集中體現。
射頻微系統技術可以推動軍民用電子信息系統在形態上向片式化、蒙皮化發展,滿足軍用[敏感詞]平臺載荷、民用產品下一代先進集成要求,推進射頻系統的芯片化、通用化,降低研制成本和周期; 在功能上推進整機的數字化、多功能一體化和智能化,催生[敏感詞]系統、民用電子產品體系變革。積極融合民用先進半導體集成技術和標準化封裝集成技術,降低軍用裝備和民用電子設施的復雜度,縮短研制周期,提高維修性,使得下一代射頻系統的規模化生產和降本增效的愿景成為可能。微系統產業的建立和完善,將促使原有產業鏈的整合,并使現有電子信息產品的形態與內涵發生重大變革。
微系統射頻模塊將電源、波控、射頻等芯片通過高密度轉接基板集成封裝在一起,實現模塊的多功能、小型化、高可靠特性。由于集成密度、工作頻率的提升,微系統產品的架構設計對結構、工藝、電路設計帶來多方面的技術挑戰: 首先,信號的隔離與互擾、電源及信號完整性、腔體效應等問題對系統布局布線提出更高要求 ; 其次,芯片熱耗及尺寸增加、互聯間距降低使得材料熱匹配導致熱應力失效問題凸顯; 最后,互聯間距的縮小及端口數量增加、高精度三維疊層、多溫度梯度焊接、產品可返修性等對工藝、材料提出更苛刻的要求 。因此,在產品研制周期不斷壓縮情況下,微系統模塊的實現及工程化應用需要結構、電訊、工藝、熱設計等多專業、多個領域協同設計。
目前,典型的微系統產品研制首先需要開展架構設計,完成產品的初步布局,確定初步工藝路線,完成材料及關鍵器件選型 ; 在此基礎上,針對材料及關鍵元器件特性,開展三維虛擬裝配、熱機應力仿真分析、電磁屏蔽隔離、腔體效應、信號及電源完整性、射頻場路的仿真分析 ,并根據仿真結果優化結構布局; 然后,基板開展布線設計及仿真驗證工作; 最后,進行實物驗證并對設計方案優化定型( 如圖 5 所示) 。

隨著微系統集成度提高,體積明顯減小,功耗明顯降低,但熱效應問題卻越發突出,可能導致器件性能惡化,甚至失效。軍用電子系統大量使用的功率元器件熱流密度更大,應用環境也更加惡劣,其熱管理難度更大。如果沒有良好的冷卻措施,未來芯片溫度將達到6 000 ℃。因此,微系統性能最終受到散熱能力的制約,其熱管理技術是目前迫切需要解決的技術難題 。針對 3D 封裝微系統,新型散熱技術逐漸得到開發,目前正在開發的五種新型熱管理技術及其特點如表 1 所示。

硅基微流道一體化集成技術是目前高效散熱研究的熱點,其中集成 TSV 的微針肋結構是微系統高效熱管理的典型技術之一。該技術在硅轉接板內制作大量的微針肋,熱量通過微針肋周圍腔體上下表面傳輸到冷卻液,與傳統微流道相比,大大提高了散熱能力。同時,微針肋內部制作的 TSV 陣列,既實現了流體的傳輸,同時又保障了電信號的高密度傳輸( 如圖6 所示) 。然而,大部分基于芯片或板級微流道的冷卻系統需要與外界有冷卻介質的接口,這種接口的體積和尺寸可能遠超過芯片的尺寸,這些問題仍需要在未來進行研究解決。
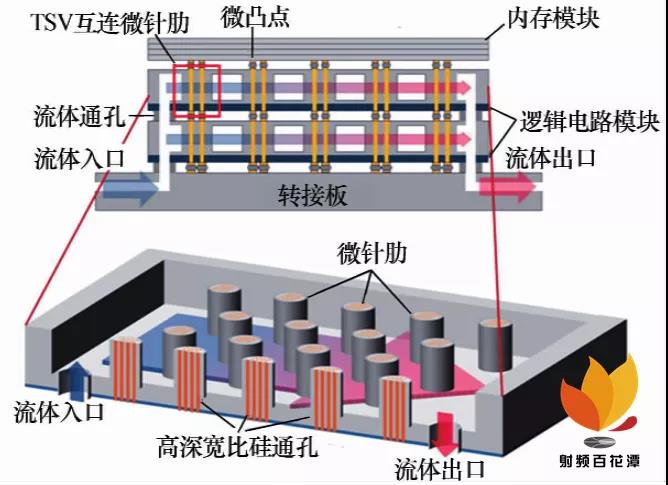
射頻微系統產品在研制及生產過程中,需要進行分層測試、三維疊層后測試,圖 7 為典型的具有射頻微系統特征的三維系統級封裝( SIP) 模塊測試模式。射頻微系統產品工作頻率高、互連間距小、輸入/出口端口多,為保證后續正常裝配使用,對無損測試要求極高,因此對測試治具的設計帶來了極大的挑戰 ,具體體現在以下四個方面:
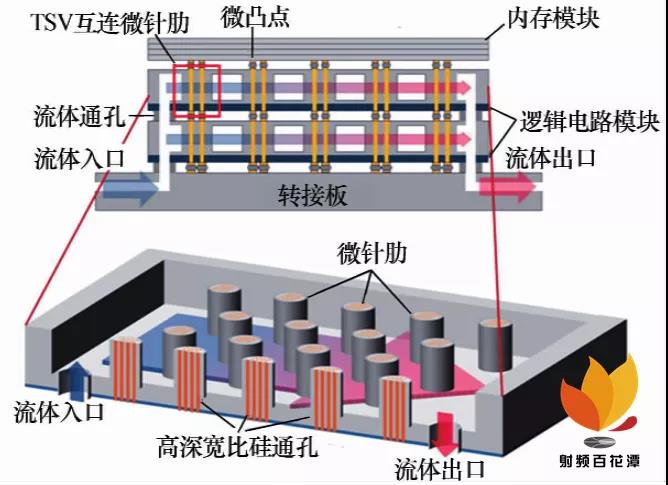

全硅基三維異構集成特征的射頻微系統焊盤間距更小( 數十微米級別) ,集成度更高,測試夾具加工精度難以滿足要求,需要借助探針臺晶圓測試的技術和理念。由于微系統三維異構集成產品正反兩面都存在射頻輸入/輸出端口,現有成熟圓片測試方法仍不能滿足要求,尤其在毫米波頻段,國內外都沒有成熟的解決方案。目前,晶圓單面測試篩選主要借助探針及定制探卡在探針臺上進行篩選測試,如圖 9 所示; 對于 Cu-pillar 等微凸點的晶圓級篩選測試,國外 Cascade 等廠商也推出了角錐隔膜( Pyramid Membrane) 微波探卡,如圖 10 所示。
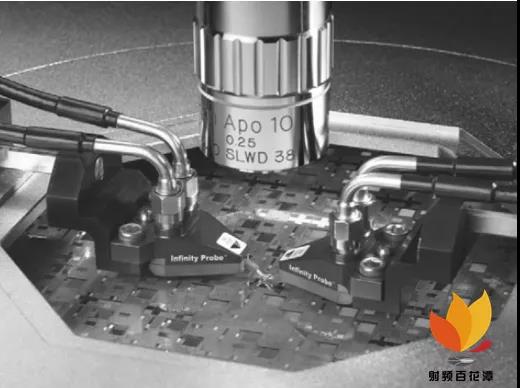

在微系統產品全生命周期中,面臨著諸多的問題與挑戰,其中加工過程中的工藝問題和應用過程中的可靠性問題是必須要考慮的部分 。當前面臨的主要工藝問題包括三維集成微系統中 TSV 的良率問題、圓片的減薄和傳送問題、多層芯片的堆疊、低弧度引線鍵合等,面臨的可靠性問題包括工藝加工可靠性、熱失配可靠性、抗干擾可靠性等 。
TSV 垂直互聯涉及的工藝眾多,包括了深孔刻蝕工藝、側壁絕緣工藝、粘附層和種子層的制備、TSV 深孔填充工藝等。每一步工藝的優良與否都會直接影響TSV 的良率,而高密度微系統集成中所應用的 TSV 數目眾多,如何保證 TSV 的良率是一個重要的工藝問題。圖 11 展示了高密度 TSV 結構及 TSV 填充不良導致的 TSV 缺陷問題。
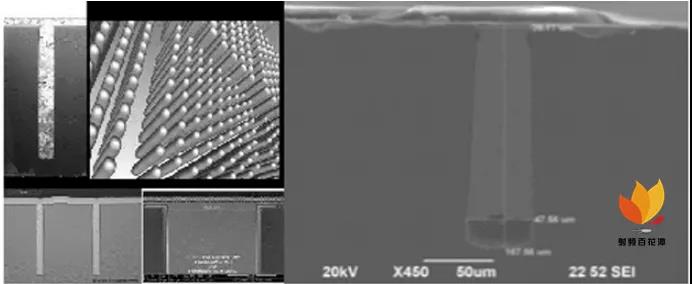
減薄工藝是微系統向小型化發展的必要工藝,可以在 Z 方向上減小系統的體積。隨著晶圓進一步超薄化( 厚度達到 50 μm) ,將呈現柔性特征,給圓片的進一步減薄和后道的傳送帶來很大困難。圖 12 呈現了圓片減薄到一定厚度之后的柔性特征。堆疊工藝是整個微系統三維異質異構集成工藝中的核心之一,也是實現微系統高密度集成不可或缺的工藝。通過堆疊工藝,不僅需要實現微系統的物理固定,還需要實現優良的電學互連。保證堆疊工藝的質量是實現微系統集成的重中之重。

一些微納制造工藝使得微系統在加工過程中就需要考慮可靠性的問題,特別是隨著微系統集成度和復雜度的提高,工藝制造流程也變得更加復雜,諸工藝流程給工藝可靠性帶來了很大的挑戰。圖 13 展示了因工藝間的相互影響導致的焊點開裂情況。與此同時,隨著 SOC 芯片及 SIP 系統熱耗的不斷提升、封裝尺寸的增大、不同材料間熱膨脹系數差異給系統的可靠性設計帶來了挑戰。圖 14 展示了封裝中的熱失配問題。
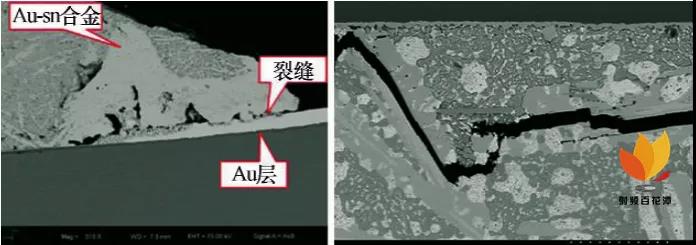
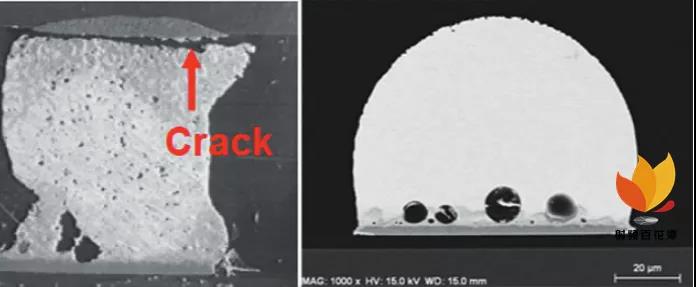
圖 14 熱失配問題示例
3 射頻微系統集成技術發展思路
( 1) 整合微系統產業鏈優勢資源,以國內高校和工業部門研究機構為代表的產學研用有機結合,建立開放的、工程化的微系統技術平臺,建立集設計、仿真、工藝、測試于一體的協同研發隊伍,形成微系統協同創新發展格局。
( 2) 加強微系統能力建設,推動現有微系統能力分布建設走向集中建設,形成研發試制快速迭代能力,加快微系統集成技術工程化轉化進度。
( 3) 優先發展符合國家急需并能在較短時間內取得關鍵突破的微系統技術; 重點推動若干具有重要產業化前景、促進國民經濟發展的關鍵微系統技術研究,鼓勵微系統關鍵基礎研究,推進原始創新。
( 4) 以代表性產品的研制成功為抓手,逐步向技術能力要求更高、性能更強的射頻微系統、光電微系統領域輻射,重點研究各領域間的共性技術,逐個突破瓶頸技術,形成多元化微型電子信息系統試制研發能力。
( 5) 注重核心關鍵人才培養,建設高素質的微系統研究、開發和應用隊伍,保障微系統技術的可持續發展。
4 結束語
微系統技術是自微電子技術問世以來,人們不斷追求電子信息裝備微型化、高性能化的必然結果,是應用創新與技術創新融合發展的典范。本文闡述了射頻微系集成技術在軍民領域的應用需求及發展趨勢,梳理了射頻微系統集成技術的體系框架,對技術面臨的挑戰與發展機遇進行了研判,同時提出了射頻微系統集成技術的進一步發展思路。微系統技術的創新發展必將推動未來[敏感詞]的顛覆性進步,還可加速民用信息化產業取得跨越式發展。
“Kinghelm”商標由金航標公司原始注冊,金航標是GPS天線北斗天線研發生產直銷廠家,在北斗GPS導航定位行業非常高的知名度和美譽度,研發生產產品廣泛應用于bds衛星導航定位無線通信等領域。主要產品包括:RJ45-RJ45網絡,網絡接口連接器、射頻連接器轉接線、同軸線纜連接器、type-c連接器、hdmi接口type-c接口、排針排母、SMA、fpc、FFC天線連接器、天線信號傳輸防水接頭、hdmi接口、usb連接器、端子端子線、端子板接線端子、接線端子排、射頻rfid標簽、定位導航天線、通訊天線天線連接線、膠棒天線吸盤天線、433天線4G天線,GPS模塊天線,RG113,RG178,RG316,FPC軟排線與FPC連接器配套,網線接口,等。廣泛應用于航天航空、通信、[敏感詞]、儀器儀表和安防、醫療等行業。
該內容來自于網絡/高速射頻百花潭,本網站僅提供轉載,該文觀點立場技術等與本網站無關,如有侵權,請聯絡我們刪除!










Copyright ? 深圳市金航標電子有限公司 版權所有 粵ICP備17113853號
